近日,由徐現(xiàn)剛教授領(lǐng)銜的 山東大學(xué)晶體材料所和南砂晶圓團(tuán)隊采用物理氣相傳輸法(PVT)擴(kuò)徑獲得了 8 英寸 4H-SiC 籽晶,用于 8 英寸導(dǎo)電型 4H-SiC 晶體生長,并加工出厚度 520 μm 的 8 英寸 4H-SiC 襯底。使用拉曼光譜、全自動顯微鏡面掃描、非接觸電阻率測試儀面掃描和高分辨 XRD 搖擺曲線對襯底的晶型、微管、電阻率和結(jié)晶質(zhì)量進(jìn)行了表征。襯底顏色均一并結(jié)合拉曼光譜表明襯底 4H-SiC 晶型面積的比例為 100%;襯底微管的密度小于 0.3cm-2;襯底電阻率范圍 20~23 mΩ·cm,平均值為 22 mΩ·cm;(004)面高分辨 X射線搖擺曲線半峰寬 32.7 弧秒,表明襯底良好的結(jié)晶質(zhì)量。
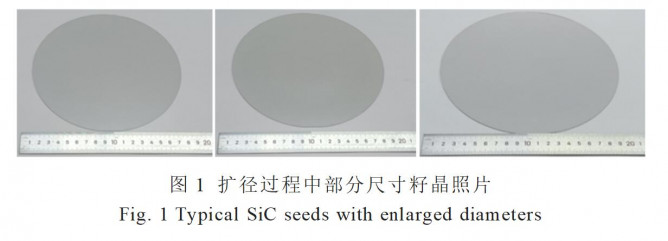




碳化硅(SiC)作為第三代寬禁帶半導(dǎo)體的核心材料之一,具有高擊穿場強(qiáng)、高飽和電子漂移速率、高熱導(dǎo)率、化學(xué)穩(wěn)定性好等優(yōu)良特性,是制作高壓、大功率、高頻、高溫和抗輻射新型功率半導(dǎo)體器件的理想材料,在電動汽車、軌道交通、高壓輸變電、光伏、5G 通訊等領(lǐng)域具有重要的應(yīng)用潛力。大尺寸高質(zhì)量 SiC單晶襯底是制造 SiC 功率半導(dǎo)體器件的基礎(chǔ)。近年來全球碳化硅領(lǐng)域以 6 英寸襯底為主,由于電動汽車滲透率不斷增高,對 SiC 器件的需求不斷增加,推升了對 SiC 襯底產(chǎn)能的需求。為增加產(chǎn)能供給,也為進(jìn)一步降低 SiC 器件的平均成本,擴(kuò)大 SiC 襯底尺寸是重要途徑之一。
為此,業(yè)界將目標(biāo)鎖定在 8 英寸 SiC 襯底上。業(yè)界領(lǐng)頭羊 Cree 在 2015 年展示了8 英寸 SiC 樣品,2019 年完成了首批 8 英寸 SiC 襯底樣品的制樣,并于今年開始量產(chǎn) 8 英寸 SiC 襯底。
山東大學(xué)晶體材料國家重點實驗室從 2002 年開始啟動碳化硅單晶的生長和襯底加工工作,攻克了多項關(guān)鍵技術(shù)。從 2018 年開始對 8 英寸籽晶和導(dǎo)電型 4HSiC 單晶生長和襯底加工進(jìn)行了研究,經(jīng)過多年的理論和技術(shù)攻關(guān),實現(xiàn)了高質(zhì)量 8 英寸導(dǎo)電型 4H-SiC 單晶和襯底的制備。
科研團(tuán)隊采用 6 英寸(0001) 表面偏向<11-20>方向 4°的 4H-SiC 碳面晶片作為籽晶,基于物理氣相傳輸法( PVT)進(jìn)行擴(kuò)徑生長,晶體生長過程中溫度控制在2100~2300℃,生長壓力小于 30 mbar。單晶多次迭代擴(kuò)大直徑,最終到達(dá) 8 英寸直徑,晶體擴(kuò)徑生長時,不進(jìn)行摻雜,背景氮濃度在 1017cm-3 量級。導(dǎo)電的 n+ 4H-SiC 單晶通過向生長氣氛中通入氮?dú)鈱崿F(xiàn),采用標(biāo)準(zhǔn)的半導(dǎo)體加工工藝加工出 8 英寸導(dǎo)電型 4H-SiC 單晶襯底。使用全自動顯微鏡測試襯底微管密度及分布;使用非接觸電阻率測試儀對襯底電阻率進(jìn)行面掃描;使用高分辨 X 射線衍射儀對襯底進(jìn)行了(004) 面高分辨 XRD 搖擺曲線測試。
結(jié)果與討論:8 英寸籽晶制備
要進(jìn)行 8 英寸的碳化硅單晶生長,首先必須要得到高結(jié)晶質(zhì)量的 8 英寸的碳化硅籽晶。為兼顧晶體質(zhì)量及擴(kuò)徑尺寸,設(shè)計了合適的溫場、流場及擴(kuò)徑裝配,以 6 英寸的碳化硅籽晶為起點,每次設(shè)定一定的擴(kuò)徑尺寸進(jìn)行單晶生長與加工。得到直徑變大的新籽晶,以此類推進(jìn)行籽晶迭代。通過多次迭代,逐步擴(kuò)大 SiC晶體的尺寸直到達(dá)到 8 英寸。籽晶直徑到達(dá) 8 英寸之后,通過多次晶體生長和加工逐步優(yōu)化晶體擴(kuò)徑區(qū)域的結(jié)晶質(zhì)量,提升 8 英寸籽晶的品質(zhì),直到滿足襯底使用要求。圖 1 為擴(kuò)徑過程中部分尺寸籽晶的照片。。
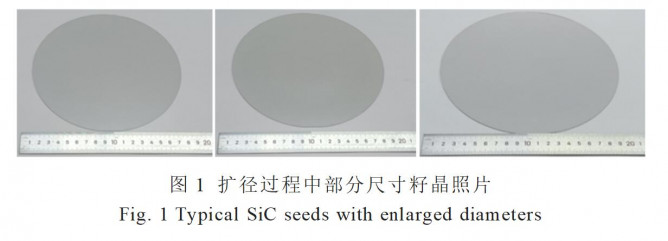
8 英寸導(dǎo)電型晶體和襯底制備
高質(zhì)量的 8 英寸籽晶獲得后,在晶體生長過程中通入一定比例的氮?dú)?,進(jìn)行 8 英寸導(dǎo)電型 SiC 晶體生長,優(yōu)化大尺寸晶體生長的溫場和流場設(shè)計,控制摻雜均勻性。晶體經(jīng)過滾圓、磨平面整形后,獲得標(biāo)準(zhǔn)直徑的 8 英寸導(dǎo)電型 4H-SiC 晶錠,如圖 2(a)所示。經(jīng)過切割、研磨、拋光后,加工獲得520μm 厚度的 8 英寸導(dǎo)電型 4H-SiC 襯底,如圖 2(b)所示。從圖 2(b)中可以看出,8 英寸 4H-SiC 襯底呈均一的棕黃色,結(jié)合拉曼測試,表明襯底中無 6H 和15R-SiC 等多型夾雜,4H 晶型面積比例達(dá)到了 100% 。

8 英寸導(dǎo)電型襯底性能表征
采用全自動顯微鏡對 8 英寸導(dǎo)電型 4H-SiC 襯底進(jìn)行面掃描,測試了微管密度及分布,如圖 3 所示,微管主要分布在 6 英寸以外的擴(kuò)徑區(qū)域,微管密度小于0.3cm-2,達(dá)到襯底使用要求。

采用非接觸式渦流法電阻率測試儀對 8 英寸導(dǎo)電型 4H-SiC 襯底的電阻率進(jìn)行面掃描,電阻率分布如圖4所示,電阻率范圍為20-23mΩ·cm,平均值22mΩ·cm,電阻率不均勻性小于 4%。

利用高分辨 X 射線衍射儀對襯底的結(jié)晶質(zhì)量進(jìn)行了表征,沿<11-20>直徑方向測試 5 點,結(jié)果如圖 5 所示。從圖中可以看出,襯底( 004)衍射面的 5 點搖擺曲線均為近對稱的單峰,無多峰出現(xiàn),說明襯底中沒有小角度晶界缺陷,5 點搖擺曲線半峰寬平均值 32.7 弧秒,表明襯底具有良好的結(jié)晶質(zhì)量。

結(jié) 論:由徐現(xiàn)剛教授領(lǐng)銜的 山東大學(xué)晶體材料所和南砂晶圓團(tuán)隊使用 PVT 生長方法制備了 8 英寸導(dǎo)電型 4H-SiC 單晶,并加工成了厚度520μm 的 8 英寸 4H-SiC 襯底。襯底微管密度小于 0.3/cm2,4H-SiC 晶型比例100%,電阻率平均值 22mΩ·cm,不均勻性小于 4%,襯底(004) 面高分辨 XRD 5點搖擺曲線半峰寬平均值 32.7 弧秒,說明襯底具有較高的結(jié)晶質(zhì)量,邊緣擴(kuò)徑區(qū)域沒有小角度晶界缺陷。襯底中各類型位錯密度的分布及控制還需要進(jìn)一步研究。
來源: 人工晶體學(xué)報、山東大學(xué)晶體材料國家重點實驗室供稿/圖
作者:楊祥龍/陳秀芳/謝雪健/彭燕/于國建/胡小波/徐現(xiàn)剛 (山東大學(xué),晶體材料國家重點實驗室,新一代半導(dǎo)體材料研究院;廣州南砂晶圓半導(dǎo)體技術(shù)有限公司),于國建 /王垚浩 (廣州南砂晶圓半導(dǎo)體技術(shù)有限公司)
